友思特应用 | 硅片上的光影贴合:UV-LED曝光系统在晶圆边缘曝光中的高效应用
导读
晶圆边缘曝光是帮助减少晶圆涂布过程中多余的光刻胶对电子器件影响的重要步骤。友思特 ALE/1 和 ALE/3 UV-LED 高性能点光源,作为唯一可用于宽带晶圆边缘曝光的 i、h 和 g 线的 LED 解决方案,可高效实现WEE系统设计和曝光需求。
晶圆边缘曝光及处理方法
晶圆曝光和光刻工艺是半导体电子器件制程中尤为重要的一个工艺步骤,影响了最终电子元器件的良品率和精确度。晶圆曝光的原理类似于“洗照片”,是将对光敏感的光刻胶均匀涂敷在硅片上,利用紫外光源发出的光线经特殊聚焦透镜通过掩模版,聚焦到晶圆表面,光刻胶遇光固化,在晶圆表面形成和掩模版一致的像,再去除掉多余的胶体,晶圆上便会留下所需要的图形结构,即经典的涂布、曝光、显影和刻蚀工艺流程。
在光刻胶涂布的过程中,由于离心作用的存在,一部分胶会被推到晶圆的边缘,形成较厚的边缘,这部分胶容易从旁晶圆边缘剥落,影响晶圆表面和内部的图形,造成颗粒污染。在表面张力的作用下,少量的胶甚至可能沿着边缘流到晶圆背面,对晶圆背面造成污染。即使采用十分谨慎的加工过程,仍然无法避免晶圆边缘的光刻胶堆积,如图1所示。
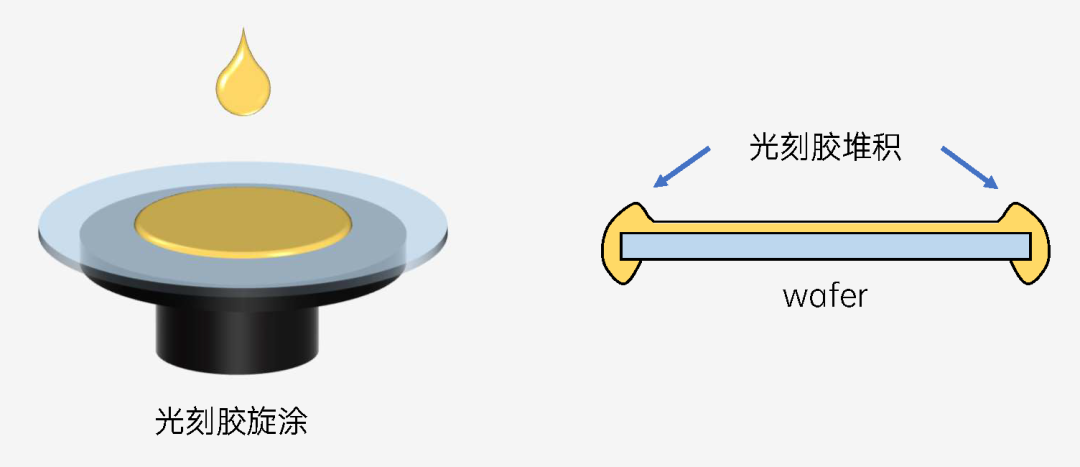
图1. 多余的胶在晶圆边缘堆积/流到晶圆背面
为了去除边缘堆积的光刻胶,需要使用到晶圆边缘处理流程。一种方法是化学去边(Chemical EBR),晶圆通过真空吸附在承载台上并进行旋转涂胶,用化学去边溶剂,喷洒少量在正反边缘处进行冲洗。缺点是去边时间长、溶剂耗材成本高、有残留区域很难洗干净,去除区域的轮廓不平滑齐整。
另一种方法为即硅片边缘曝光(Wafer Edge Exposure, WEE)。边缘曝光单元主要由晶圆承载台、预对准系统、光源(有遮光板)、光强计构成,如图2所示。晶圆真空吸附在承载台上,先由预对准系统找到曝光起始位置,再由光源经过遮光板形成的光斑照射在晶圆边缘,通过承载台的旋转及系统的计算控制,来实现可控宽度、位置的边缘曝光。WEE方法的优点在于生产效率高、装置成本低、过程易控制、边缘轮廓整齐,缺点是因光的散射会导致轮廓存在较大的 slope。
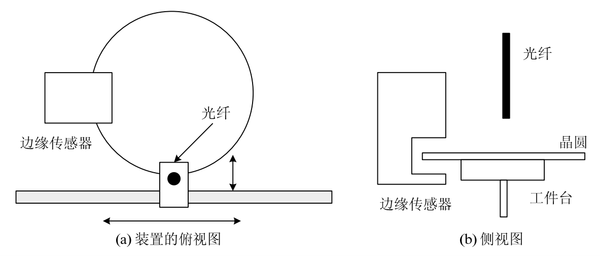
图2. 边缘曝光装置结构示意图
WEE 工具对于精准的晶圆工艺流程是必须的。当采用正性光刻胶时,WEE 工具主要用于允许边缘处的绝对最小曝光宽度,以最大限度地减少边缘处的良率损失。WEE 不仅可以提高产量,还可以最大限度地减少电镀接触区域的贵金属的浪费。当采用负性抗蚀剂时,WEE 工具用于提供一种保护或密封晶圆边缘的方法,以防止污染物到达WEE曝光路径边界内的器件。
友思特 WEE 曝光光源系统
WEE 硬件通常由扫描仪、旋转设备和高性能点光源组成,该光源具有用于晶圆边缘曝光的光学元件。友思特 ALE/1 和 ALE/3 UV-LED 光源正好适合这些设置:它们是唯一可用于宽带晶圆边缘曝光的 i、h 和 g 线的 LED 解决方案。
环保型 UV-LED 光源 ALE/1 和 ALE/3 可以精确控制,以确保最佳曝光效果。此外,它们还提高了系统在日常运行中的效率:一方面,UV-LED 的使用寿命更长,意味着系统的停机时间更短。另一方面,光源的可更换 LED 模块可在现场快速轻松地进行维护。

图3. 使用 ALE/1 光源进行WEE工艺
友思特 UV-LED 光源具有与汞蒸气灯非常相似的光谱功率,特别适合在现有的 WEE 工艺中替代传统汞灯技术。宽带 UV-LED 光源和解决方案与传统汞蒸气灯的比较显示出出色的光谱一致性,同时具有显著的性能优势。使用友思特 UV-LED 成像系统,客户可以完全控制:单独配置和控制i、h和g线(中心波长 365、405和436nm 周围的光谱范围),或将它们一起使用以获得最佳性能。曝光过程非常精确,切换时间不到 1ms,并且可以长期保持稳定。

图4. ALE/1、ALE/3光源与汞灯的功率对比
WEE系统设计参数
边缘锐度:指强度从0到100%或从100%到0的梯度/边缘的宽度,单位:mm。实际曝光过程中不存在0%和100%的均匀度,所以实际上边缘锐度指的是:若均匀性为90%,则其宽度与强度从0到100%的边缘宽度相似。如图5所示,边缘锐度大约是 5mm。
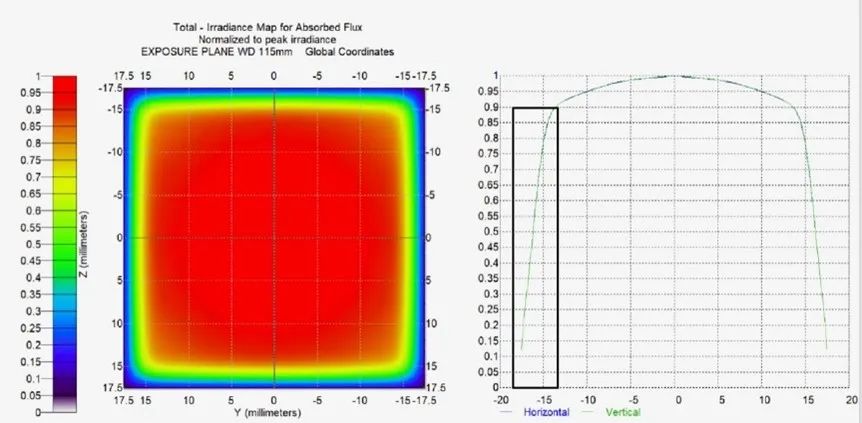
图5. 边缘锐度与均匀性示例
均匀性:从中心到边缘不同位置的曝光强度的差异,单位:%。
曝光面积:曝光晶圆边缘的宽度以及单次曝光的面积大小,单位:mm*mm。
焦距深度:单位:mm。晶圆被固定时不会直线移动,但会上下摆动并产生微小的数值位移,这是不可避免的,因为晶圆既不能是100%的平面,也不能是100%精确的机械零件。
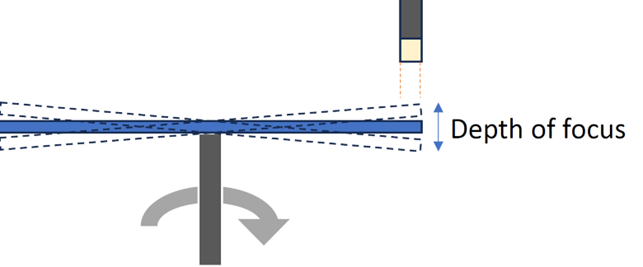
图6. 焦距深度示例
曝光强度:被曝光区域上的曝光功率与曝光面的比值,单位:mW/cm² 或W/cm²。
设备空间:指设备中需要集成光源的可用空间,以及放置在设备内部的位置和方式
以上这些参数并非独立的性质,而是互相影响着最终的曝光结果,其关系如图7所示。
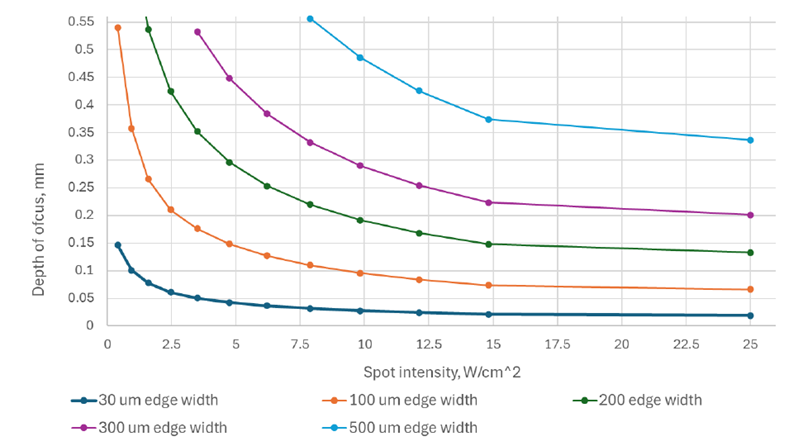
图7. 参数关系图示例
参考文献:
[1] WEE系统的设计与应用,苗 涛 张 军 邹春太,信息工程
[2] 厚胶边缘去除方法研究,关丽,孙洪君,现代工业经济和信息化
[3] 边缘处理对硬掩膜很重要. Laura Peters. 集成电路应用
[4] 超大规模集成电路先进光刻理论与应用. 韦亚一.北京科学出版社
友思特紫外曝光光源方案
ALE/1 UV-LED

友思特 ALE/1 紫外光源,采用先进的无汞设计,结合了汞放电灯的辐射功率和光谱特性,以及 LED 技术的工艺优势,可实现高达 30W 的光输出。基于模块化的平台,能在光路中组合多达5个高性能 LED,实现光谱组成的高度灵活性和定制化。
ALE/3 UV-LED

友思特 ALE/3 紫外光源,支持多种波长固化模式,可在较高波段进行曝光、高强度较低波段完成固化,形成完全固化的粘合层和完美的表面,可实现高达 15W 光输出。具备LED工业稳定性和TCO优势,易于集成到新的和现有设置中,在UV固化和晶圆曝光应用中完美替代200W汞灯。
了解更多?欢迎探索丰富案例:https://viewsitec.com/semi-lighting-source-2/uv-light-source/
原文地址:https://blog.csdn.net/m0_49762095/article/details/140687112
免责声明:本站文章内容转载自网络资源,如本站内容侵犯了原著者的合法权益,可联系本站删除。更多内容请关注自学内容网(zxcms.com)!
