SSD在低地球轨道卫星应用中的挑战
随着太空技术的迅速发展,越来越多的卫星被发射到低地球轨道(Low-Earth-Orbit,缩写LEO,又称“近地轨道”),以支持通信、地球观测、技术开发等多种任务。然而,这些卫星在轨道运行期间面临着严峻的辐射环境考验,这对卫星上的存储设备—固态硬盘(SSD)提出了极高的要求。

截至2023年5月1日,运营中的卫星总数为7560颗,其中通信卫星占比最大,为75%。

在LEO卫星的海拔分布中,不同的应用和所有者分布在不同的海拔范围内。例如,SpaceX、OneWeb等公司在LEO卫星领域占据重要地位。

太空辐射测试:TID与SEE
随着太空探索和技术的发展,越来越多的航天器被送入轨道执行各种任务。这些航天器不仅需要在极端的温度条件下工作,还需要面对宇宙射线带来的挑战。为了确保航天器及其组件能够在太空中正常运作,必须对其进行严格的辐射测试。
TID(Total Ionizing Dose)测试
TID测试旨在评估电子设备在长期暴露于辐射环境下的累积效应,这些辐射主要是由电子和质子组成的。测试的目的是确定设备是否能在预期的工作寿命内维持功能,并识别出可能因辐射损伤而失效的部件。TID测试通常使用的单位是格雷(Gray,缩写为Gy)或千拉德(KRad,缩写为Si),其中1格雷等于100拉德。例如,对于某些低地球轨道(LEO)应用来说,5年的任务可能需要30千拉德到50千拉德的TID测试,而在测试过程中,被测设备(如固态硬盘)通常是不加屏蔽的。

随着卫星轨道高度的增加,它将穿越不同的辐射区域,包括范艾伦带。在更高的轨道上,卫星会接收到更多的辐射,导致TID水平上升。使用5毫米厚的铝屏蔽层可以在一定程度上减少辐射对设备的影响。屏蔽层可以吸收部分辐射,从而降低设备内部的TID水平。但是,即使有屏蔽,设备仍然需要设计成能够承受一定的辐射剂量。
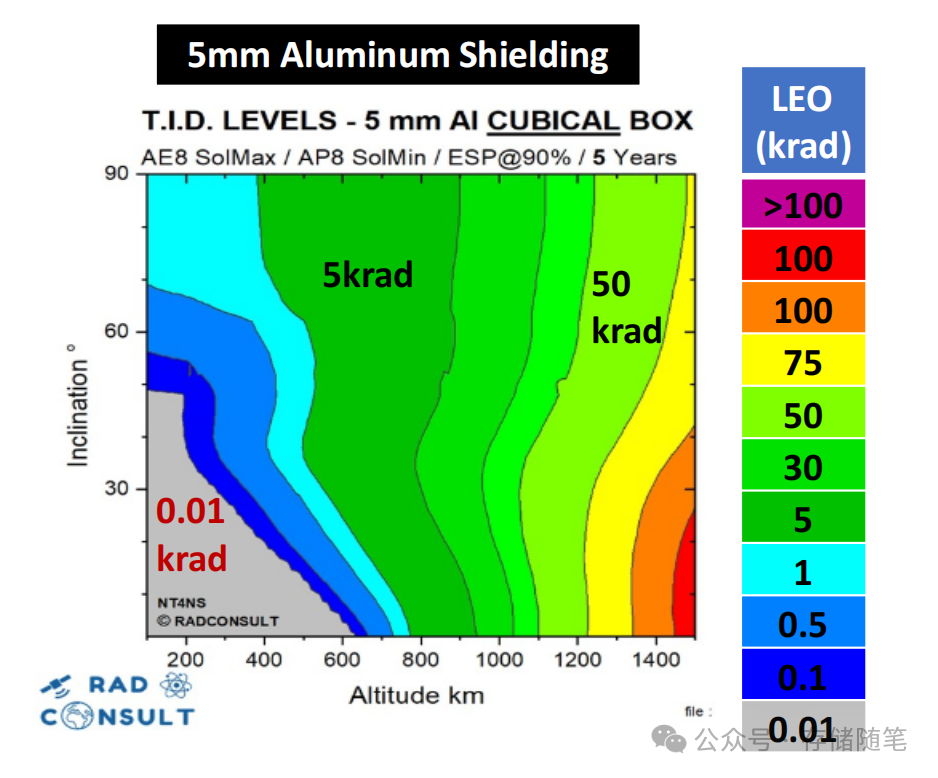
根据TID4NS模型,我们来看一下不同海拔高度下的TID水平,假设任务期限为五年,并且使用5毫米厚的铝制屏蔽层:
-
在1400公里高度,即使有5毫米铝屏蔽,TID水平仍然高达30 krad。这表明在这个高度,即使使用了屏蔽层,电子设备仍然面临较高的辐射风险。
-
在大约1200公里的高度,由于距离地球更远,卫星更容易受到太阳风和宇宙射线的影响,TID水平约为50千拉德(krad)。
-
在大约800公里的高度,TID水平显著降低至5 krad。这说明随着轨道高度的降低,屏蔽层的效果更加明显,TID水平也随之减少。
-
在大约600公里的高度,TID水平进一步降低至0.01千拉德,但这个数值可能是低估的。这是因为模拟模型可能存在局限性,无法完全捕捉到真实环境中的所有变量。实际操作中,还需要综合考虑其他因素,比如太阳活动周期的变化等。

随着海拔高度的增加,尤其是在1000公里以上的LEO轨道,被困质子的数量显著增加。这些质子主要来自于太阳风和宇宙射线,当它们进入地球磁场时会被捕获,并在范艾伦带内积累。被困质子的能量很高,能够穿透大多数常规屏蔽材料,并在电子设备内部产生电离效应,导致TID水平上升。
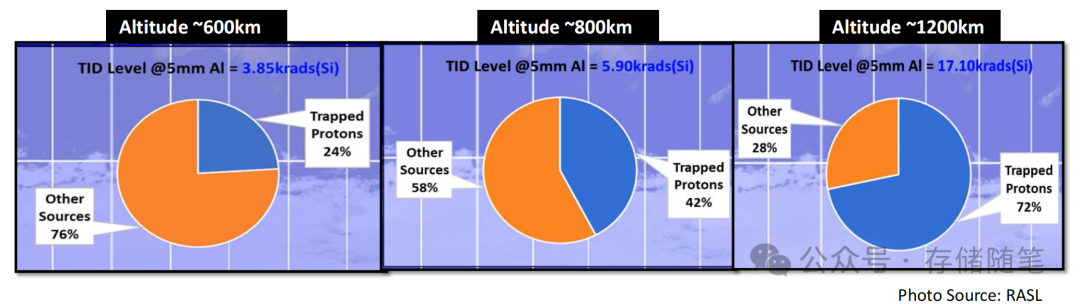
SEE(Single Event Effects)测试
与TID测试关注的长期辐射效应不同,SEE测试侧重于单个电离粒子撞击或与电子设备相互作用所造成的瞬间影响。这种类型的测试通常使用质子或重离子来模拟空间辐射环境。测试包括质子SEE和重离子SEE测试,以评估设备对不同类型粒子的响应。SEE测试的结果通常用线性能量传递(LET)来描述,其单位是兆电子伏特每毫克每平方厘米(MeV/mg·cm²)。测试结果帮助工程师了解设备对单次事件的敏感程度,从而采取适当的防护措施。
测试方法
-
质子SEE测试:使用质子束模拟太空中的高能质子对设备的影响。
-
重离子SEE测试:利用重离子束模拟更重的粒子(如氦核)对设备的影响,这类测试对于评估在较高LET值下的设备响应特别重要。
TID和SEE测试是确保航天器及其载荷能够在太空辐射环境中安全运行的重要手段。通过这些测试获得的数据,设计师们能够改进硬件设计,编写更强大的固件算法,并采取有效的防护措施,从而提升整个系统的可靠性和数据完整性。
随着航天器在低地球轨道(LEO)中的应用日益广泛,确保其电子设备在长期暴露于辐射环境下的可靠性至关重要。本文将基于一个具体的测试案例,详细分析在总电离剂量(TID)测试(40千拉德,krad)后,纠错码(ECC)的表现情况。
通过对Micron公司64层3D TLC闪存在40krad TID测试后的ECC分析,我们可以看到,在LEO环境下,通过有效的ECC机制和固件错误处理,能够显著提高电子设备的可靠性和数据完整性。对于非操作状态下的设备,则需要进一步研究如何在不消耗过多资源的情况下提供必要的保护。这些发现对于未来LEO应用中的存储解决方案设计具有重要的指导意义。
测试背景与设置
-
辐射源:使用钴-60(Co-60)作为γ射线源。
-
测试样品:
-
-
运行样机(Operational Sample):在TID测试期间处于工作状态。
-
备用样机(Passive Sample):作为冷备份样机,未安装使用。
-
-
测试前筛选:在TID测试前,对两组样品进行了100%的NAND ECC筛选。
-
样品类型:Micron公司的64层3D TLC闪存(运行于SLC模式)。
-
测试结果:运行样机在测试过程中表现良好,直到TID测试结束(40krad(Si)),相当于LEO中10年的任务寿命。
测试发现
-
无坏块:
-
-
在两种样品中均未观察到坏块(No UECC,即未检测到无法纠正的错误)。
-
在高剂量的辐射测试中,ECC机制证明了其有效性。即使在达到40krad的剂量后,两组样品均未出现无法纠正的错误(UECC),这表明ECC机制能够有效检测并纠正由辐射引起的错误。
-
-
非操作样机的误码率更高:
-
-
未运行的备用样机(Unbiased/Non-operational Sample)显示的错误比特数高于运行样机(Biased/Operational Sample)。
-
运行样机在测试期间持续工作的状态表明,固件中的错误处理机制在实时操作中发挥了重要作用。通过不断地监测和纠正错误,固件能够保持数据的完整性,从而使运行样机的错误比特数低于未运行的备用样机。
-
-
更多操作,更低的错误率:
-
-
测试结果表明,在操作期间,固件(FW)的错误处理机制有助于恢复错误,导致运行样机的错误率低于备用样机。
-
备用样机在测试中表现出更高的错误比特数,这可能是由于在非操作状态下缺乏固件的实时监控和纠错功能。这也提示我们在设计冗余系统时,应考虑到即使是在非操作状态下的样机也需要相应的保护措施。
-

在低地球轨道(LEO)的高轨道(1000公里及以上)中,航天器面临更大的单次事件翻转(Single Event Upset, SEU)风险。在1000公里及以上的LEO轨道,航天器有更多时间处于内范艾伦带内。该区域内存在大量被困质子(trapped protons)和银河宇宙射线(Galactic Cosmic Rays, GCR),这些高能粒子增加了单次事件翻转(SEU)的风险。

尽管适当的屏蔽可以减少太阳活动期间的SEU发生率,但对于银河宇宙射线引起的SEU,由于其能量极高,屏蔽效果有限。银河宇宙射线带来的SEU风险具有一个最低限,这个限值在实际应用中难以进一步降低。SEU与SEFI的区别如下:
-
SEU(单次事件翻转)
-
-
SEU通常指的是单个电离粒子穿过半导体器件时,导致器件内部存储单元状态发生改变的现象。这种现象可能导致数据错误或设备功能异常。
-
-
SEFI(单次事件功能中断)
-
-
SEFI是指单个粒子事件导致设备暂时失去功能,但可以通过重新启动(power cycling)来恢复。相比于SEU,SEFI不会永久损坏设备,但会导致设备暂时停止工作。
-
在航天器及其他高性能计算系统中,确保数据的完整性和可靠性是至关重要的。控制器中的存储器,如SRAM、DRAM和NAND Flash,都需要有效的错误检测与纠正机制来对抗单次事件效应(SEE)及其他形式的辐射影响。
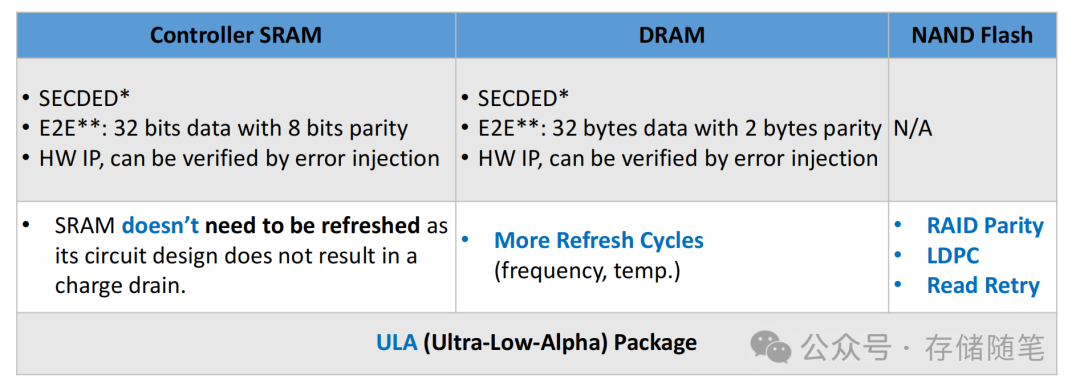
-
由于SRAM的稳定性较高,通常不需要像DRAM那样频繁的刷新操作。然而,在高辐射环境中,仍有可能受到单次事件效应(SEE)的影响。如果需要增强SRAM的抗辐射能力,可以考虑使用超低阿尔法粒子(ULA)封装材料来减少内部辐射影响。
-
DRAM需要定期刷新来维持数据的准确性,因为其存储单元依赖电容器存储电荷,随着时间推移会有电荷流失的情况。使用SECDED机制可以检测并纠正单个比特位的错误,同时检测到两个比特位的错误。同时,需要E2E(端到端保护),32字节数据加上2字节的奇偶校验信息,确保数据在传输过程中的完整性。
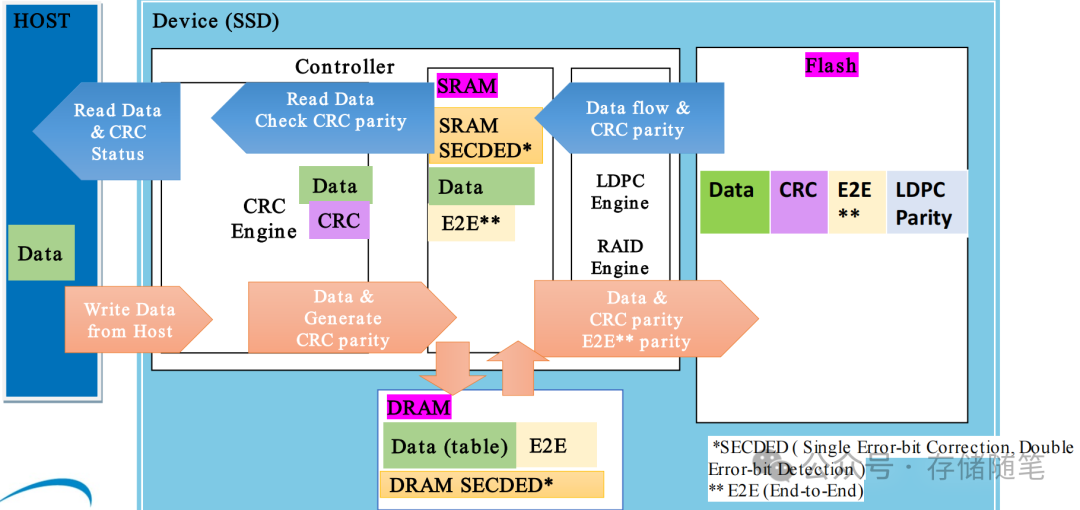
-
NAND Flash是非易失性存储器,常用于大容量数据存储,如SSD等设备中。需要的错误检测与纠正机制,包括LDPC(Low-Density Parity-Check Code)、Read Retry、ULA(Ultra-Low-Alpha)Package(使用超低阿尔法粒子封装材料,以减少封装材料本身对存储单元的辐射影响)。
随着电子设备向更高密度、更复杂功能以及更低功耗方向发展,其对辐射的敏感度也在急剧增加。在这种背景下,使用超低阿尔法粒子(Ultra Low Alpha, ULA)封装材料成为了提高电子设备可靠性的关键。封装材料的阿尔法粒子控制水平是指单位时间内每平方厘米材料表面释放的阿尔法粒子数量。以下是不同级别的封装材料的对比:
-
普通材料
-
-
阿尔法粒子控制水平:0.002 计数/小时·平方厘米(cph/cm²)
-
-
低阿尔法材料
-
-
阿尔法粒子控制水平:0.01 计数/小时·平方厘米(cph/cm²)
-
-
超低阿尔法材料
-
-
阿尔法粒子控制水平:通常低于0.01 计数/小时·平方厘米(cph/cm²)
-
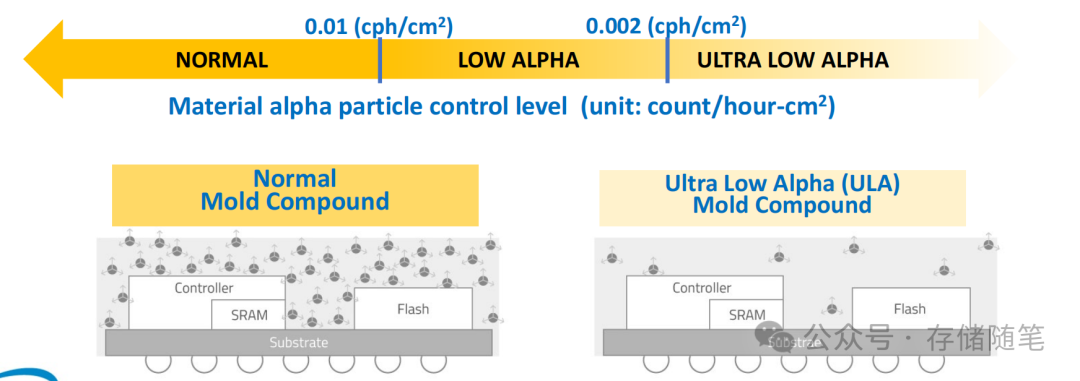
随着半导体技术的进步,硅片越来越薄,电路密度越来越高,功耗也越来越低。这使得电子设备对封装材料中的阿尔法粒子更加敏感。阿尔法粒子是由放射性物质衰变产生的高能粒子。在封装材料中,如果存在放射性杂质,这些杂质会释放阿尔法粒子,这些粒子可能会穿透到封装的半导体器件内部,导致以下几种问题:
-
单次事件效应(SEE):阿尔法粒子可能会导致半导体器件内部的电荷积累,从而引起单次事件效应,如单次事件翻转(SEU)或单次事件功能中断(SEFI)。
-
总电离剂量(TID):长期暴露在阿尔法粒子辐射下,可能导致半导体器件的性能退化,如阈值电压漂移等。
参考文献:FMS 2024-ATP Electronics, Inc-《SSD Challenges in Low-Earth-Orbit (LEO) Applications》
如果您看完有所受益,欢迎点击文章底部左下角“关注”并点击“分享”、“在看”,非常感谢!
精彩推荐:
原文地址:https://blog.csdn.net/zhuzongpeng/article/details/142612274
免责声明:本站文章内容转载自网络资源,如本站内容侵犯了原著者的合法权益,可联系本站删除。更多内容请关注自学内容网(zxcms.com)!
